知识点8:
离子注入是为了将掺杂剂(如硼、磷等)精确引入硅晶片的近表面区域,以改变其电学性质。
工艺过程:
- 电离与加速:掺杂剂原子在离子源中被电离(带电),通过高压电场(几千伏至百万伏)加速,形成高能离子束。
- 轰击与注入:高能离子轰击硅片表面并嵌入晶格中。
- 晶格损伤与修复:离子注入会导致硅晶格损伤,需通过后续高温退火修复,同时激活掺杂剂(使其占据晶格位置并发挥电学作用)。
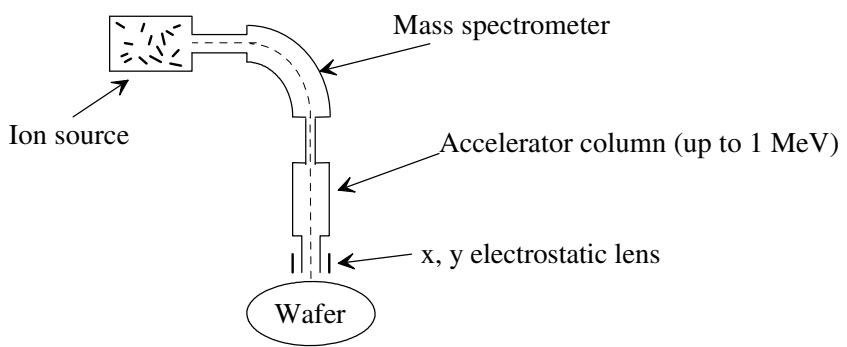
离子交换器简图
图中:
- 离子源:通过射频(RF)场产生离子。
- 质谱仪:筛选特定质量的离子(确保纯度)。
- 加速器:离子经高压加速。
- 静电透镜:扫描离子束至晶圆表面,控制剂量均匀性。
注入掺杂分布模型的数学描述:

 :深度x处的掺杂浓度。
:深度x处的掺杂浓度。 :峰值浓度(最大掺杂浓度)。
:峰值浓度(最大掺杂浓度)。 :投影射程(离子平均穿透深度,比如大部分离子停在硅片下0.1微米处)。
:投影射程(离子平均穿透深度,比如大部分离子停在硅片下0.1微米处)。- Δ
 :离散参数(离子分布的标准偏差,反映浓度分布的宽度,数值越大,说明有的离子钻得深,有的钻得浅)。
:离散参数(离子分布的标准偏差,反映浓度分布的宽度,数值越大,说明有的离子钻得深,有的钻得浅)。
通俗的话来解释:就像往沙堆里扔一把弹珠:大部分弹珠停在某个深度(![]() ),这里弹珠最密集(
),这里弹珠最密集(![]() )。但有些弹珠弹得远,有些弹得近(Δ
)。但有些弹珠弹得远,有些弹得近(Δ![]() 决定分散程度)。整体分布是一个“钟形曲线”(高斯分布)。
决定分散程度)。整体分布是一个“钟形曲线”(高斯分布)。

图中显示理想的植入体轮廓分布,即分布模型所示
上图可见:
- 浓度峰值位于表面下方Rp处,呈高斯分布。
- 注入能量越高,Rp越大(离子穿透更深)
剂量计算数学公式:
![]()
![]() 为总注入剂量(单位面积离子数)。
为总注入剂量(单位面积离子数)。
简单说就是把硅片切成无数薄片,数每一片里的离子,最后全部加起来。相当于统计“总共扔了多少颗弹珠到沙堆里”。
掩膜的使用:
- 局部注入:通过掩模(如氧化物、光刻胶)阻挡离子,仅在暴露区域注入。
- 掩模厚度要求:必须足够厚以完全阻挡离子到达硅衬底。
- 对比扩散工艺的优势:
- 低温工艺:避免高温对器件的热影响。
- 精确控制:通过调节能量和剂量,可精准控制掺杂浓度与深度。















)
网络层 IPv4、CIDR(使用子网掩码进行网络划分)、NAT在私网划分中的应用)

